Master IC Packaging
Fehleranalyse
mit TESCAN-Lösungen
Erleben Sie die Leistungsfähigkeit von Plasma FIB-REM
und den innovativen TESCAN Large Volume Workflow
Neue Veröffentlichung
Optimierung der Fehleranalyse bei Halbleitern: Die Leistungsfähigkeit der Kombination von Laserablation und Xe-Plasma FIB-REM
Die Ausschöpfung des vollen Potenzials der eigenständigen ps-Laserablation in Kombination mit Plasma FIB-REM macht die schnelle und genaue Fehleranalyse in mikroelektronischen Bauteilen einfacher als je zuvor. Erfahren Sie in unserem neuesten Beitrag, wie Sie die Produktivität durch gleichzeitigen, kontinuierlichen Systembetrieb maximieren können!

Mit der Weiterentwicklung von Halbleitern stehen die Labors für IC Packaging Failure Analysis vor beispiellosen Herausforderungen. Die Bewältigung komplexer Anforderungen an die Fehleranalyse von Halbleitern, sich entwickelnde Gehäusearchitekturen, schrumpfende Merkmale und das Aufkommen exotischer und empfindlicher Materialien ist eine gewaltige Aufgabe. In der Zwischenzeit liefern sich globale Halbleiterunternehmen ein Wettrennen um die Entwicklung von hochmodernen Chips, Gehäusen und Chiplets für anspruchsvolle Kommunikationsgeräte und vielseitige Unterhaltungselektronik.
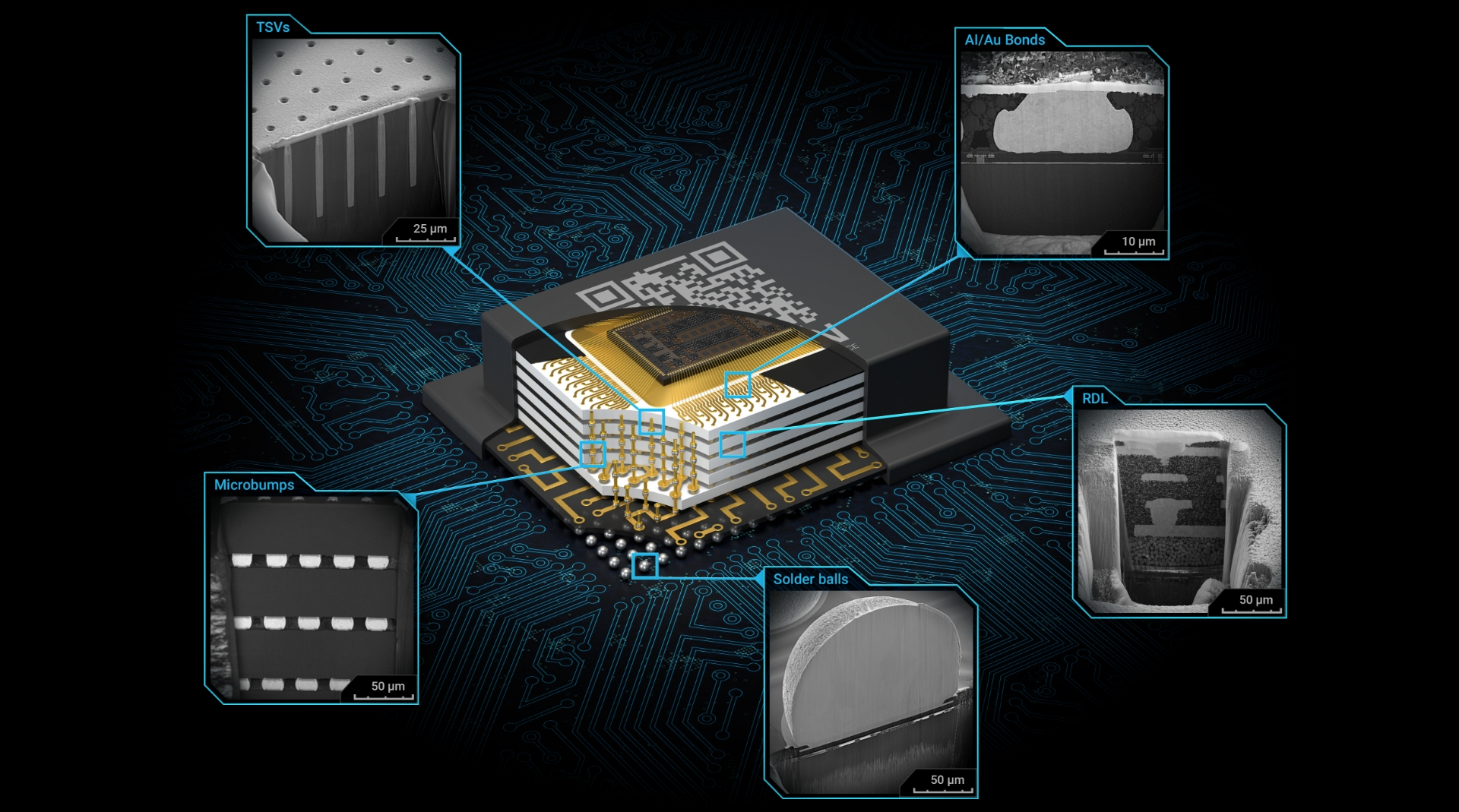
Allgemeine Probleme beim IC-Design und bei der Herstellung von IC-Packages:
- Lose leitfähige Partikel
- Probleme mit der Beschichtung
- Fehler bei Draht- und Bandverbindungen
- Feuchtigkeitsbedingte Ausfälle
- Fehler im Package (Verkapselung)
- Bildung von Intermetallen
- EOS- / ESD-bezogen
- Ermüdungsrisse
- Hohlräume in Kontakthöckern (Micro-bumps)
- Leiterbahnunterbrechungen und Elektromigration
- Verzug von TSV-Chips
Nachhaltige IC-Packaging-Fehleranalyse mit modernsten TESCAN-Lösungen
Eine nachhaltige IC Packaging Fehleranalyse basiert auf vielfältigem Fachwissen und einer breiten Palette von zerstörungsfreien und zerstörenden Verfahren, die von FA-Tools bereitgestellt werden. TESCAN unterstützt seine Kunden mit innovativen Lösungen, einschließlich zerstörungsfreier Mikro-CT-Fehleranalyseanwendungen, Plasma FIB-SEM SOLARIS X und dem Large Volume Workflow, der Laserablation und Plasma FIB-SEM-Technologie nahtlos kombiniert.
Darüber hinaus arbeitet TESCAN mit europäischen Partnern im Rahmen von FA4.0 zusammen, einem Projekt, das darauf abzielt, fließendere Arbeitsabläufe für die Fehleranalyse zwischen zahlreichen Fehleranalyseinstrumenten sowie ein Datenmanagement für die Digitalisierung von Fehleranalyselabors in der Mikroelektronik zu schaffen. Erfahren Sie mehr über FA4.0 in unserer Rubrik Einblicke!
Überzeugen Sie sich selbst davon, wie diese Lösungen die Fehleranalyse an IC-Packages auf ein neues Niveau heben.
Entdecken Sie unsere hochmodernen Lösungen
Entdecken Sie TESCAN FIB-SEM
Erleben Sie die ultimative Plasma FIB-REM-Plattform für tiefe Schnitte und hochauflösende Endpunkte in der IC Packaging Fehleranalyse.
Tauchen Sie ein in den Large Volume Workflow

Nutzen Sie die Synergie von Plasma FIB-REM, einem separaten Laser- und anderen FA-Tools für die Probenvorbereitung und -analyse im Millimeterbereich.
Haben Sie Fragen?
Sind Sie an einer virtuellen Demo interessiert?
Unser weltweites Team beantwortet gerne Fragen zu TESCAN FIB-SEMs und unseren Lösungen für die Fehleranalyse von Halbleitern und IC-Verpackungen.

